集成电路制造的过程就是硅片附加值快速增长的过程,对设备可靠性要求极高。例如,一个典型的 12 寸原始硅片,价格约 120 美元,经过约 500~800 个工艺步骤,加工 40~60 天后,其价值能提高到约 3000 美元;假定一个芯片制造厂的月产能40000 片~100000 片,其月产出可以达到 1.2 亿~3 亿美元,甚至更高。因此,一个运行稳健的芯片制造厂几乎是个“印钞机”。反之,如果芯片生产线出现故障,包括停电、设备维修、工艺问题等,即使几个小时的损失也非常巨大。集成电路的制造是一个复杂且耗时的过程。 首先要利用设计自动化软件开始电路设计,然后将集成电路设计的版图转印到石英玻璃上的铬膜层形成光刻板或倍缩光刻板;另一方面,由石英砂提炼出的初级硅经过纯化后拉成单晶硅棒,然后切片做成晶圆。晶圆经过边缘化和表面处理,再与光刻板/倍缩光刻板一起送到半导体制造厂制造集成电路芯片。
IC 制造核心工艺图
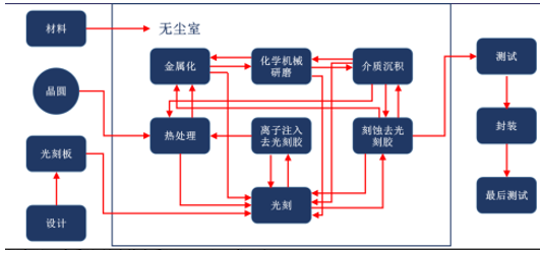
资料来源:公开资料整理
1、 晶圆制造
单晶硅晶圆是集成电路制造中最常用的半导体晶圆材料。半导体工业中常用的生产单晶硅的方法包括 CZ 法和 FZ 法,其中又以 CZ 法最为常见。CZ 法中使用射频或电阻加热线圈,臵于慢速转动的石英坩埚内高纯度电子级硅材料在 1415℃时融化。将一个安装在慢速转动夹具上的单晶硅籽晶棒逐步降低到熔融状态的硅中,接着籽晶体表面浸在熔融的硅中并开始融化。当系统达到热稳定时,籽晶晶体被缓慢拉出并同时把熔融的硅拉出来,使其沿着籽晶晶体的方向凝固。在 48 小时甚至更长的提拉过程后,便可以形成高纯度的单晶硅棒。全自动单晶硅生长炉,通过自动化控制系统控制晶体直径的温度和提拉速率,可以控制晶体的直径。 硅晶体中的氧和碳杂质的浓度则会受到晶体生长的周围压力、提拉和旋转速率、以及晶体直径与长度比等参数的影响;因此,提拉出更大直径、更长、更纯的单晶硅,是全自动单晶硅生长炉的核心目标。目前,晶盛机电的长晶炉已经具备了 12 英寸单晶硅棒的生产能力。
晶体 CZ 提拉方法示意图
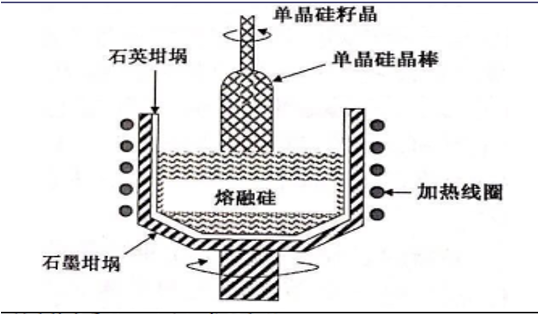
资料来源:公开资料整理
提拉出的单晶棒,需要经过切除、侧边研磨后,锯切成晶片;然后将晶圆边缘圆滑处理、粗磨、刻蚀、化学机械研磨后, 就可以作为重要基材送到芯片厂进行进一步加工。
不同晶圆尺寸的晶圆厚度
晶圆尺寸(mm) | 厚度(μm) | 面积(cm³) | 重量(g) |
50.8(2in) | 279 | 20.26 | 1.32 |
76.2(3in) | 381 | 45.61 | 4.05 |
100 | 525 | 78.65 | 9.67 |
125 | 625 | 112.72 | 17.87 |
150 | 675 | 176.72 | 27.82 |
200 | 725 | 314.16 | 52.98 |
300 | 775 | 706.21 | 127.62 |
450 | 925±25 | 1590.43 | 342.77 |
资料来源:公开资料、智研咨询整理
2、加热工艺
硅的氧化物二氧化硅是一种非常稳定且坚固的电介质材料,并容易通过高温过程形成,这也是硅成为 IC 产业主要半导体材料的原因之一; IC 的制造过程通常由氧化工艺开始,这个过程需要生长一层二氧化硅保护硅的表面; 在 IC 流程中硅晶圆经过多次高温炉和快速加热处理过程。硅芯片的制造过程中,高温工艺的温度范围一般在 700~1200℃,涉及扩散、氧化、沉积、退火等工艺。 加热工艺一般在高温炉/扩散炉中进行。 高温炉需要具备稳定性、均匀性、精确的温度控制、低微粒污染、高生产率、可靠性等特征。
水平式高温炉示意图
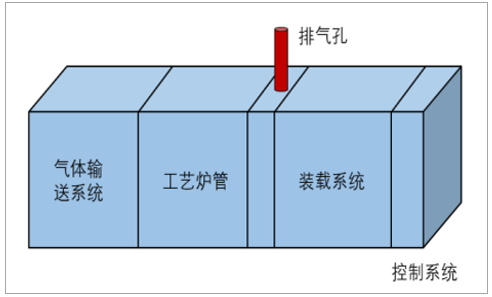
资料来源:公开资料整理
高温炉一般包括控制系统、工艺炉管、气体输送系统、气体排放系统、 装载系统等基本组件; 应用在低压化学气相沉积工艺的高温炉需要多加一个真空系统。 控制系统用于控制工艺程序,比如晶圆装载与卸载、每个工艺的处理时间、温度、升温速率、气体的流量与排出等;气体输送系统负责处理工艺气体并将气体输送到所需的炉管中; 装载系统负责晶圆装载、卸载及临时储存; 炉管是晶圆进行高温加热过程的区域,由石英炉管、反应室、加热器等组成; 工艺中的副产品以及没有用到的原材料气体,则通过排放系统从炉管或反应室中排放出去。早期的 IC 生产普遍采用扩散掺杂半导体,由于最常用的硅掺杂工具是高温石英炉,因此,虽然现在扩散掺杂工艺应用越来越少,“扩散炉”的名称一直被延续下来。氧化是最重要的工艺之一,是一种添加工艺,将氧气加入到硅晶圆后在晶圆表面形成二氧化硅。 而形成的二氧化硅可以作为扩散遮蔽层,在离子注入等其他多个工艺中用于避免硅片受污染。 常用的氧化工艺包括干氧氧化、湿氧氧化、高压氧化等,其核心是控制氧化的速率、氧化层的厚度。氧化是一种很慢的过程,甚至在温度超过 1000℃的高温炉中都需要花费数小时才能生长出厚度约 0.5μm 的氧化层;因此,氧化工艺通常都是在高温氧化炉中批量处理,每批次处理 100~200片晶圆。高温化学气相沉积,是一种在晶圆表面沉积一层薄膜层的添加工艺。 高温化学气相沉积过程包括外延硅沉积、选择性外延工艺、多晶硅沉积和低压化学气相沉积、氮化硅沉积。高温炉在批量处理数百片晶圆时广泛应用,但由于热容量很大,所以反应炉管或反应室的温度只能缓慢升高或降低。而快速加热工艺用于处理单个晶圆,可以以75℃/s~200℃/s 的速率升温。离子注入退火、硅化物退火和超薄二氧化硅层生长都使用快速加热工艺系统。 快速加热工艺系统一般都具有一个石英反应室和许多石英件,利用红外线辐射产生密集的热量,晶圆的温度可以由红外线高温计准确测量。
快速加热反应室示意图
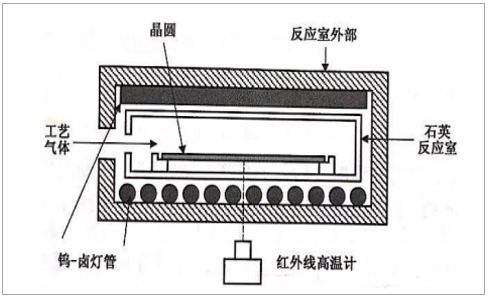
资料来源:公开资料整理
3、光刻工艺
光刻是图形化工艺中将设计好的图形从光刻板或倍缩光刻板转印到晶圆表面的技术。 由于元器件和电路设计都是利用刻蚀和离子注入将定义在光刻胶上的图形转移到晶圆表面,晶圆表面上的光刻胶图形由光刻技术决定,因此光刻是集成电路制造的核心。从裸片晶圆到键合垫片的刻蚀和去光刻胶为止,即使最简单的 MOS IC 芯片都需要 5 道光刻工艺,先进的集成电路芯片可能需要 30 道光刻工艺步骤。 在集成电路长达 6~8周的制造过程中,光刻工艺几乎耗费了整个晶圆制造时间的 40%~50%。光刻技术的基本要求是高分辨率、高感光度、精准度、低缺陷密度。 光刻技术主要包括光刻胶涂覆、对准和曝光、光刻胶显影三个工艺流程。 首先在晶圆表面涂上一层光刻胶(感光薄膜),这层光刻胶经过光刻板或倍缩光刻板的紫外线曝光,光刻板上的明区或暗区通过绘图机根据集成电路设计而成。穿过明区的紫外线使曝光的光刻胶化学成分因光化学反应而发生变化。
光刻流程示意图
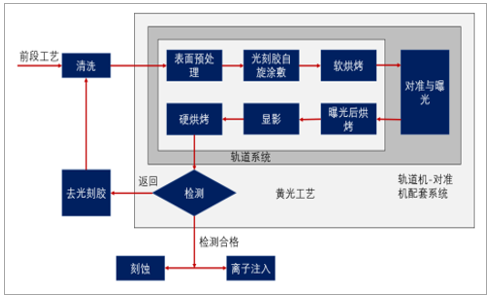
资料来源:公开资料整理
光刻机作为 IC 制造过程中最核心的设备,其价值量占芯片厂设备总投资的比例高达 20%~22%。 荷兰 ASML 在高端光刻机领域占据绝大部分市场份额,其单台设备价值甚至高达 1 亿美元,部分高端机型仍然对大陆技术封锁。 我国上海微电子装备已经研制出终端光刻机,形成了产品系列,但是与外资品牌仍有一定差距。
4、离子注入工艺
离子注入是一种添加工艺,利用高能量带电离子束注入的形式,将掺杂物原子强行掺入半导体中。 这也是目前半导体工业中主要的掺杂方法,可以通过掺杂 N 型或 P 型掺杂物实现对半导体导电率的控制。离子注入机包含气体系统、电机系统、真空系统、控制系统和射线系统。 其中,射线系统是离子注入及最重要的部分,涉及离子源、萃取电极、质谱仪、后段加速系统、等离子注入系统及终端分析仪。
离子注入机示意图
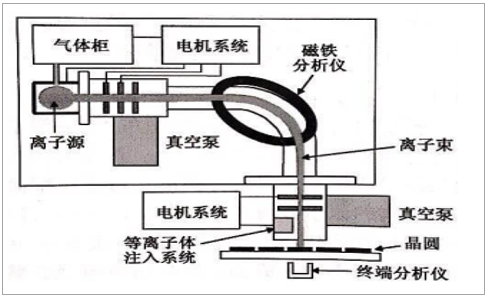
资料来源:公开资料整理
5、等离子体工艺
等离子体工艺在半导体制造中应用广泛,包括等离子体刻蚀、等离子体化学气相沉积、物理气相沉积等。 比如, IC 制造中的所有图形化刻蚀均为等离子体刻蚀或干法刻蚀,等离子体增强式化学气相沉积(PECVD)和高密度等离子体化学气相沉积(HDP CVD)广泛用于电介质沉积。离子注入使用等离子体源制造晶圆掺杂所需的离子,并提供电子中和晶圆表面上的正电荷。物理气相沉积(PVD)利用离子轰击金属靶表面,使金属溅镀沉积于晶圆表面。遥控等离子体广泛应用于清洁机台的反应室、薄膜去除及薄膜沉积工艺。
PECVD 反应室示意图
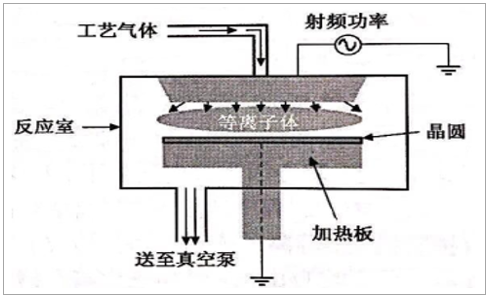
资料来源:公开资料整理
等离子刻蚀反应室示意图

资料来源:公开资料整理
遥控等离子体系统示意图
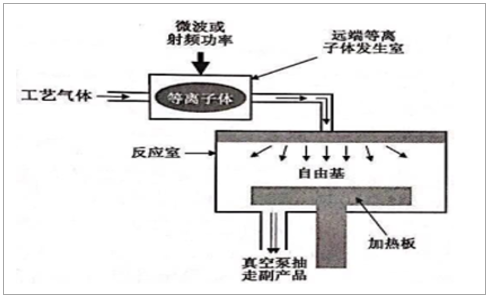
资料来源:公开资料整理
6、刻蚀工艺
刻蚀是移除晶圆表面材料,达到 IC 设计要求的一种工艺过程。 刻蚀有两种:一种是图形化刻蚀,这种刻蚀能将指定区域的材料去除,如将光刻胶或光刻版上的图形转移到衬底薄膜上;另一种是整面全区域刻蚀,即去除整个表面薄膜达到所需的工艺要求。 刻蚀方法有电介质刻蚀、单晶硅刻蚀、多晶硅刻蚀、氮化硅刻蚀、金属刻蚀等。湿法刻蚀是利用化学溶液溶解晶圆表面的材料,达到制作器件和电路的要求,包括刻蚀、冲洗、甩干三个基本过程。等离子体刻蚀是利用气态化学刻蚀剂与材料产生反应来刻蚀材料并形成可以从衬底上移除的挥发性副产品,又叫干法刻蚀。
多晶硅栅刻蚀工艺流程
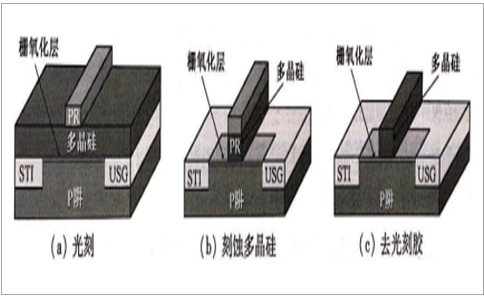
资料来源:公开资料整理
相关报告:智研咨询网发布的《2017-2023年中国半导体化学品市场分析及发展趋势研究报告》
 智研咨询 - 精品报告
智研咨询 - 精品报告

2026-2032年中国半导体先进封装行业市场全景评估及投资前景研判报告
《2026-2032年中国半导体先进封装行业市场全景评估及投资前景研判报告》共九章,包含全球及中国半导体先进封装企业案例解析,中国半导体先进封装行业政策环境及发展潜力,中国半导体先进封装行业投资策略及规划建议等内容。

 公众号
公众号
 小程序
小程序
 微信咨询
微信咨询























